ĪĪĪĪIGBTš²╩Ūū„×ķĒśæ¬▀@ĘNę¬Ū¾Č°ķ_░lĄ─Ż¼╦³╩Ūė╔MOSFET(▌ö╚ļ╝ē)║═PNPŠ¦¾w╣▄(▌ö│÷╝ē)Å═║ŽČ°│╔Ą─ę╗ĘNŲ„╝■Ż¼╝╚ėąMOSFETŲ„╝■“īäė╣”┬╩ąĪ║═ķ_ĻP╦┘Č╚┐ņĄ─╠ž³c(┐žųŲ║═Ēææ¬)Ż¼ėųėąļpśOą═Ų„╝■’¢║═ē║ĮĄĄ═Č°╚▌┴┐┤¾Ą─╠ž³c(╣”┬╩╝ē▌^×ķ─═ė├)Ż¼Ņl┬╩╠žąįĮķė┌MOSFET┼c╣”┬╩Š¦¾w╣▄ų«ķgŻ¼┐╔š²│Ż╣żū„ė┌Äū╩«KHzŅl┬╩ĘČć·ā╚ĪŻ╗∙ė┌▀@ą®ā׫ɥ─╠žąįŻ¼IGBTę╗ų▒ÅVĘ║╩╣ė├į┌│¼▀^300VļŖē║Ą─æ¬ė├ųąŻ¼─ŻēK╗»Ą─IGBT┐╔ęįØMūŃĖ³Ė▀Ą─ļŖ┴„é„ī¦ę¬Ū¾Ż¼Ųõæ¬ė├ŅIė“▓╗öÓ╠ßĖ▀Ż¼Į±║¾īóėąĖ³┤¾Ą─░lš╣ĪŻ
ĪĪĪĪIGBTĄ─ĮYśŗ┼c╠žąįŻ║
ĪĪĪĪ╚ńłD1╦∙╩Š×ķę╗éĆN£ŽĄ└į÷ÅŖą═Į^Šē¢┼ļpśOŠ¦¾w╣▄ĮYśŗŻ¼ N+ģ^ĘQ×ķį┤ģ^Ż¼ĖĮė┌Ųõ╔ŽĄ─ļŖśOĘQ×ķį┤śO(╝┤░l╔õśOE)ĪŻN╗∙śOĘQ×ķ┬®ģ^ĪŻŲ„╝■Ą─┐žųŲģ^×ķ¢┼ģ^Ż¼ĖĮė┌Ųõ╔ŽĄ─ļŖśOĘQ×ķ¢┼śO(╝┤ķTśOG)ĪŻ£ŽĄ└į┌Šo┐┐¢┼ģ^▀ģĮńą╬│╔ĪŻį┌CĪóEā╔śOų«ķgĄ─Pą═ģ^(░³└©P+║═P-ģ^Ż¼£ŽĄ└į┌įōģ^ė“ą╬│╔)Ż¼ĘQ×ķü壎Ą└ģ^(Subchannel region)ĪŻČ°į┌┬®ģ^┴Ēę╗é╚Ą─P+ģ^ĘQ×ķ┬®ūó╚ļģ^(Drain injector)Ż¼╦³╩ŪIGBT╠žėąĄ─╣”─▄ģ^Ż¼┼c┬®ģ^║═ü壎Ą└ģ^ę╗Ųą╬│╔PNPļpśOŠ¦¾w╣▄Ż¼Ų░l╔õśOĄ─ū„ė├Ż¼Ž“┬®śOūó╚ļ┐šč©Ż¼▀Mąąī¦ļŖš{ųŲŻ¼ęįĮĄĄ═Ų„╝■Ą─═©æBļŖē║ĪŻĖĮė┌┬®ūó╚ļģ^╔ŽĄ─ļŖśOĘQ×ķ┬®śO(╝┤╝»ļŖśOC)ĪŻ
ĪĪĪĪłD1 N£ŽĄ└į÷ÅŖą═Į^Šē¢┼ļpśOŠ¦¾w╣▄ĮYśŗ
ĪĪĪĪIGBTĄ─ķ_ĻPū„ė├╩Ū═©▀^╝ėš²Ž“¢┼śOļŖē║ą╬│╔£ŽĄ└Ż¼ĮoPNP(įŁüĒ×ķNPN)Š¦¾w╣▄╠ß╣®╗∙śOļŖ┴„Ż¼╩╣IGBTī¦═©ĪŻĘ┤ų«Ż¼╝ėĘ┤Ž“ķTśOļŖē║Ž¹│²£ŽĄ└Ż¼ŪąöÓ╗∙śOļŖ┴„Ż¼╩╣IGBTĻPöÓĪŻIGBTĄ─“īäėĘĮĘ©║═MOSFET╗∙▒ŠŽÓ═¼Ż¼ų╗ąĶ┐žųŲ▌ö╚ļśON-£ŽĄ└MOSFETŻ¼╦∙ęįŠ▀ėąĖ▀▌ö╚ļūĶ┐╣╠žąįĪŻ«öMOSFETĄ─£ŽĄ└ą╬│╔║¾Ż¼Å─P+╗∙śOūó╚ļĄĮN-īėĄ─┐šč©(╔┘ūė)Ż¼ī”N-īė▀MąąļŖī¦š{ųŲŻ¼£pąĪN-īėĄ─ļŖūĶŻ¼╩╣IGBTį┌Ė▀ļŖē║ĢrŻ¼ę▓Š▀ėąĄ═Ą─═©æBļŖē║ĪŻ
ĪĪĪĪIGBT╩Ūė╔MOSFET║═GTR╝╝ągĮY║ŽČ°│╔Ą─Å═║Žą═ķ_ĻPŲ„╝■Ż¼╩Ū═©▀^į┌╣”┬╩MOSFETĄ─┬®śO╔ŽūĘ╝ėp+īėČ°śŗ│╔Ą─Ż¼ąį─▄╔Žę▓╩ŪĮY║Ž┴╦MOSFET║═ļpśOą═╣”┬╩Š¦¾w╣▄Ą─ā׳cĪŻN+ģ^ĘQ×ķį┤ģ^Ż¼ĖĮė┌Ųõ╔ŽĄ─ļŖśOĘQ×ķį┤śO(╝┤░l╔õśOE)Ż╗P+ģ^ĘQ×ķ┬®ģ^Ż¼Ų„╝■Ą─┐žųŲģ^×ķ¢┼ģ^Ż¼ĖĮė┌Ųõ╔ŽĄ─ļŖśOĘQ×ķ¢┼śO(╝┤ķTśOG)ĪŻ£ŽĄ└į┌Šo┐┐¢┼ģ^▀ģĮńą╬│╔ĪŻį┌CĪóEā╔śOų«ķgĄ─Pą═ģ^(░³└©P+║═P-ģ^)(£ŽĄ└į┌įōģ^ė“ą╬│╔)ĘQ×ķü壎Ą└ģ^(Subchannel region)ĪŻČ°į┌┬®ģ^┴Ēę╗é╚Ą─P+ģ^ĘQ×ķ┬®ūó╚ļģ^(Drain injector)Ż¼╦³╩ŪIGBT╠žėąĄ─╣”─▄ģ^Ż¼┼c┬®ģ^║═ü壎Ą└ģ^ę╗Ųą╬│╔PNPļpśOŠ¦¾w╣▄Ż¼Ų░l╔õśOĄ─ū„ė├Ż¼Ž“┬®śOūó╚ļ┐šč©Ż¼▀Mąąī¦ļŖš{ųŲŻ¼ęįĮĄĄ═Ų„╝■Ą─═©æBē║ĮĄĪŻĖĮė┌┬®ūó╚ļģ^╔ŽĄ─ļŖśOĘQ×ķ┬®śO(╝┤╝»ļŖśOC)ĪŻ
ĪĪĪĪIGBT╩Ūė╔ę╗éĆN£ŽĄ└Ą─MOSFET║═ę╗éĆPNPą═GTRĮM│╔Ż¼╦³īŹļH╩ŪęįGTR×ķų„ī¦į¬╝■Ż¼ęįMOSFET×ķ“īäėį¬╝■Ą─Å═║Ž╣▄ĪŻIGBT│²┴╦ā╚║¼PNPŠ¦¾w╣▄ĮYśŗŻ¼▀ĆėąNPNŠ¦¾w╣▄ĮYśŗŻ¼įōNPNŠ¦¾w╣▄═©▀^īóŲõ╗∙śO┼c░l╔õśOČ╠Įėų┴MOSFETĄ─į┤śOĮī┘Č╦╩╣ų«ĻPöÓĪŻIGBTĄ─4īėPNPNĮYśŗŻ¼ā╚║¼Ą─PNP┼cNPNŠ¦¾w╣▄ą╬│╔┴╦ę╗éĆ┐╔┐ž╣ĶĄ─ĮYśŗŻ¼ėą┐╔─▄Ģ■įņ│╔IGBTĄ─Ūµų∙ą¦æ¬ĪŻIGBT┼cMOSFET▓╗═¼Ż¼ā╚▓┐ø]ėą╝─╔·Ą─Ę┤Ž“Č■śO╣▄Ż¼ę“┤╦į┌īŹļH╩╣ė├ųą(Ėąąįžō▌d)ąĶę¬┤Ņ┼õ▀m«öĄ─┐ņ╗ųÅ═Č■śO╣▄ĪŻ
ĪĪĪĪIGBTĄ─└ĒŽļĄ╚ą¦ļŖ┬Ę╝░īŹļHĄ╚ą¦ļŖ┬Ę╚ńŽ┬łD╦∙╩ŠŻ║

ĪĪĪĪłD3 IGBTĄ─└ĒŽļĄ╚ą¦ļŖ┬Ę╝░īŹļHĄ╚ą¦ļŖ┬Ę
ĪĪĪĪė╔Ą╚ą¦ļŖ┬Ę┐╔īóIGBTū„×ķī”PNPļpśOŠ¦¾w╣▄║═╣”┬╩MOSFET▀Mąą▀_┴ųŅD▀BĮė║¾ą╬│╔Ą─å╬Ų¼ą═Bi-MOSŠ¦¾w╣▄ĪŻ
ĪĪĪĪę“┤╦Ż¼į┌ķTśO-░l╔õśOų«ķg═Ō╝ėš²ļŖē║╩╣╣”┬╩MOSFETī¦═©ĢrŻ¼PNPŠ¦¾w╣▄Ą─╗∙śO-╝»ļŖśOŠ═▀BĮė╔Ž┴╦Ą═ļŖūĶŻ¼Å─Č°╩╣PNPŠ¦¾w╣▄╠Äė┌ī¦═©ĀŅæBŻ¼ė╔ė┌═©▀^į┌┬®śO╔ŽūĘ╝ėp+īėŻ¼į┌ī¦═©ĀŅæBŽ┬Ż¼Å─p+īėŽ“n╗∙śOūó╚ļ┐šč©Ż¼Å─Č°ę²░lé„ī¦ąį─▄Ą─▐DūāĪŻę“┤╦Ż¼╦³┼c╣”┬╩MOSFETŽÓ▒╚Ż¼┐╔ęįĄ├ĄĮśOĄ═Ą─═©æBļŖūĶĪŻ
ĪĪĪĪ┤╦║¾Ż¼╩╣ķTśO-░l╔õśOų«ķgĄ─ļŖē║×ķ0VĢrŻ¼╩ūŽ╚╣”┬╩MOSFET╠Äė┌öÓ┬ĘĀŅæBŻ¼PNPŠ¦¾w╣▄Ą─╗∙śOļŖ┴„▒╗ŪąöÓŻ¼Å─Č°╠Äė┌öÓ┬ĘĀŅæBĪŻ
ĪĪĪĪ╚ń╔Ž╦∙╩÷Ż¼IGBT║═╣”┬╩MOSFETę╗śėŻ¼═©▀^ļŖē║ą┼╠¢┐╔ęį┐žųŲķ_═©║═ĻPöÓäėū„ĪŻ
ĪĪĪĪIGBTĄ─╣żū„╠žąįŻ║
ĪĪĪĪ1.ņoæB╠žąį
ĪĪĪĪIGBT Ą─ņoæB╠žąįų„ę¬ėąĘ³░▓╠žąįĪó▐DęŲ╠žąį║═ķ_ĻP╠žąįĪŻ
ĪĪĪĪIGBT Ą─Ę³░▓╠žąį╩ŪųĖęį¢┼į┤ļŖē║Ugs ×ķģóūā┴┐ĢrŻ¼┬®śOļŖ┴„┼c¢┼śOļŖē║ų«ķgĄ─ĻPŽĄŪ·ŠĆĪŻ▌ö│÷┬®śOļŖ┴„▒╚╩▄¢┼į┤ļŖē║Ugs Ą─┐žųŲŻ¼Ugs įĮĖ▀Ż¼ Id įĮ┤¾ĪŻ╦³┼cGTR Ą─▌ö│÷╠žąįŽÓ╦ŲŻ¼ę▓┐╔Ęų×ķ’¢║═ģ^1 ĪóĘ┼┤¾ģ^2║═ō¶┤®╠žąį3▓┐ĘųĪŻį┌Įžų╣ĀŅæBŽ┬Ą─IGBTŻ¼š²Ž“ļŖē║ė╔J2 ĮY│ąō·Ż¼Ę┤Ž“ļŖē║ė╔J1ĮY│ąō·ĪŻ╚ń╣¹¤oN+ŠÅø_ģ^Ż¼ätš²Ę┤Ž“ūĶöÓļŖē║┐╔ęįū÷ĄĮ═¼śė╦«ŲĮŻ¼╝ė╚ļN+ŠÅø_ģ^║¾Ż¼Ę┤Ž“ĻPöÓļŖē║ų╗─▄▀_ĄĮÄū╩«Ę³╦«ŲĮŻ¼ę“┤╦Ż¼Ž▐ųŲ┴╦IGBT Ą──│ą®æ¬ė├ĘČć·ĪŻ
ĪĪĪĪIGBT Ą─▐DęŲ╠žąį╩ŪųĖ▌ö│÷┬®śOļŖ┴„Id ┼c¢┼į┤ļŖē║Ugs ų«ķgĄ─ĻPŽĄŪ·ŠĆĪŻ╦³┼cMOSFETĄ─▐DęŲ╠žąįŽÓ═¼Ż¼«ö¢┼į┤ļŖē║ąĪė┌ķ_åóļŖē║Ugs(th) ĢrŻ¼IGBT ╠Äė┌ĻPöÓĀŅæBĪŻį┌IGBT ī¦═©║¾Ą─┤¾▓┐Ęų┬®śOļŖ┴„ĘČć·ā╚Ż¼ Id ┼cUgs│╩ŠĆąįĻPŽĄĪŻūŅĖ▀¢┼į┤ļŖē║╩▄ūŅ┤¾┬®śOļŖ┴„Ž▐ųŲŻ¼ŲõūŅ╝čųĄę╗░Ń╚Ī×ķ15Vū¾ėęĪŻ
ĪĪĪĪIGBT Ą─ķ_ĻP╠žąį╩ŪųĖ┬®śOļŖ┴„┼c┬®į┤ļŖē║ų«ķgĄ─ĻPŽĄĪŻIGBT ╠Äė┌ī¦═©æBĢrŻ¼ė╔ė┌╦³Ą─PNP Š¦¾w╣▄×ķīÆ╗∙ģ^Š¦¾w╣▄Ż¼╦∙ęįŲõB ųĄśOĄ═ĪŻ▒M╣▄Ą╚ą¦ļŖ┬Ę×ķ▀_┴ųŅDĮYśŗŻ¼Ą½┴„▀^MOSFET Ą─ļŖ┴„│╔×ķIGBT ┐éļŖ┴„Ą─ų„ę¬▓┐ĘųĪŻ┤╦ĢrŻ¼═©æBļŖē║Uds(on) ┐╔ė├Ž┬╩Į▒Ē╩ŠŻ║
ĪĪĪĪUds(on) = Uj1 + Udr + IdRoh
ĪĪĪĪ╩ĮųąUj1 Ī¬Ī¬ JI ĮYĄ─š²Ž“ļŖē║Ż¼ŲõųĄ×ķ0.7 Ī½1V ;Udr Ī¬Ī¬öUš╣ļŖūĶRdr ╔ŽĄ─ē║ĮĄ;Roh Ī¬Ī¬£ŽĄ└ļŖūĶĪŻ
ĪĪĪĪ═©æBļŖ┴„Ids ┐╔ė├Ž┬╩Į▒Ē╩ŠŻ║
ĪĪĪĪIds=(1+Bpnp)Imos
ĪĪĪĪ╩ĮųąImos Ī¬Ī¬┴„▀^MOSFET Ą─ļŖ┴„ĪŻ
ĪĪĪĪė╔ė┌N+ ģ^┤µį┌ļŖī¦š{ųŲą¦æ¬Ż¼╦∙ęįIGBT Ą─═©æBē║ĮĄąĪŻ¼─═ē║1000VĄ─IGBT ═©æBē║ĮĄ×ķ2 Ī½ 3V ĪŻIGBT ╠Äė┌öÓæBĢrŻ¼ų╗ėą║▄ąĪĄ─ą╣┬®ļŖ┴„┤µį┌ĪŻ
ĪĪĪĪ1äėæB╠žąį
ĪĪĪĪIGBTį┌ķ_═©▀^│╠ųąŻ¼┤¾▓┐ĘųĢrķg╩Ūū„×ķMOSFET üĒ▀\ąąĄ─Ż¼ų╗╩Ūį┌┬®į┤ļŖē║Uds Ž┬ĮĄ▀^│╠║¾Ų┌Ż¼ PNPŠ¦¾w╣▄ė╔Ę┼┤¾ģ^ų┴’¢║═Ż¼ėųį÷╝ė┴╦ę╗Č╬čė▀tĢrķgĪŻtd(on) ×ķķ_═©čė▀tĢrķgŻ¼tri×ķļŖ┴„╔Ž╔²ĢrķgĪŻīŹļHæ¬ė├ųą│ŻĮo│÷Ą─┬®śOļŖ┴„ķ_═©Ģrķgton╝┤×ķtd (on) trių«║═ĪŻ┬®į┤ļŖē║Ą─Ž┬ĮĄĢrķgė╔tfe1║═tfe2ĮM│╔ĪŻ
ĪĪĪĪIGBTĄ─ė|░l║═ĻPöÓę¬Ū¾ĮoŲõ¢┼śO║═╗∙śOų«ķg╝ė╔Žš²Ž“ļŖē║║═žōŽ“ļŖē║Ż¼¢┼śOļŖē║┐╔ė╔▓╗═¼Ą─“īäėļŖ┬Ę«a╔·ĪŻ«ö▀xō±▀@ą®“īäėļŖ┬ĘĢrŻ¼▒žĒÜ╗∙ė┌ęįŽ┬Ą─ģóöĄüĒ▀MąąŻ║Ų„╝■ĻPöÓŲ½ų├Ą─ę¬Ū¾Īó¢┼śOļŖ║╔Ą─ę¬Ū¾Īó─═╣╠ąįę¬Ū¾║═ļŖį┤Ą─ŪķørĪŻę“×ķIGBT¢┼śO- ░l╔õśOūĶ┐╣┤¾Ż¼╣╩┐╔╩╣ė├MOSFET“īäė╝╝ąg▀Mąąė|░lŻ¼▓╗▀^ė╔ė┌IGBTĄ─▌ö╚ļļŖ╚▌▌^MOSFET×ķ┤¾Ż¼╣╩IGBTĄ─ĻPöÓŲ½ē║æ¬įō▒╚įSČÓMOSFET“īäėļŖ┬Ę╠ß╣®Ą─Ų½ē║Ė³Ė▀ĪŻ
ĪĪĪĪIGBTĄ─ķ_ĻP╦┘Č╚Ą═ė┌MOSFETŻ¼Ą½├„’@Ė▀ė┌GTRĪŻIGBTį┌ĻPöÓĢr▓╗ąĶ꬞ō¢┼ē║üĒ£p╔┘ĻPöÓĢrķgŻ¼Ą½ĻPöÓĢrķgļS¢┼śO║═░l╔õśO▓ó┬ōļŖūĶĄ─į÷╝ėČ°į÷╝ėĪŻIGBTĄ─ķ_åóļŖē║╝s3Ī½4VŻ¼║═MOSFETŽÓ«öĪŻIGBTī¦═©ĢrĄ─’¢║═ē║ĮĄ▒╚MOSFETĄ═Č°║═GTRĮėĮ³Ż¼’¢║═ē║ĮĄļS¢┼śOļŖē║Ą─į÷╝ėČ°ĮĄĄ═ĪŻ
ĪĪĪĪIGBTĄ─╣żū„įŁ└ĒŻ║
ĪĪĪĪIGBT╩ŪīóÅŖļŖ┴„ĪóĖ▀ē║æ¬ė├║═┐ņ╦┘ĮKČ╦įOéõė├┤╣ų▒╣”┬╩MOSFETĄ─ūį╚╗▀M╗»ĪŻė╔ė┌īŹ¼Fę╗éĆ▌^Ė▀Ą─ō¶┤®ļŖē║BVDSSąĶę¬ę╗éĆį┤┬®═©Ą└Ż¼Č°▀@éĆ═©Ą└ģsŠ▀ėą║▄Ė▀Ą─ļŖūĶ┬╩Ż¼ę“Č°įņ│╔╣”┬╩MOSFETŠ▀ėąRDS(on)öĄųĄĖ▀Ą─╠žš„Ż¼IGBTŽ¹│²┴╦¼Fėą╣”┬╩MOSFETĄ─▀@ą®ų„ę¬╚▒³cĪŻļm╚╗ūŅą┬ę╗┤·╣”┬╩MOSFET Ų„╝■┤¾Ę∙Č╚Ė─▀M┴╦RDS(on)╠žąįŻ¼Ą½╩Ūį┌Ė▀ļŖŲĮĢrŻ¼╣”┬╩ī¦═©ōp║─╚į╚╗ę¬▒╚IGBT ╝╝ągĖ▀│÷║▄ČÓĪŻ▌^Ą═Ą─ē║ĮĄŻ¼▐DōQ│╔ę╗éĆĄ═VCE(sat)Ą──▄┴”Ż¼ęį╝░IGBTĄ─ĮYśŗŻ¼═¼ę╗éĆś╦£╩ļpśOŲ„╝■ŽÓ▒╚Ż¼┐╔ų¦│ųĖ³Ė▀ļŖ┴„├▄Č╚Ż¼▓ó║å╗»IGBT“īäėŲ„Ą─įŁ└ĒłDĪŻ
ĪĪĪĪN£Žą═Ą─IGBT╣żū„╩Ū═©▀^¢┼śO-░l╔õśOķg╝ėķyųĄļŖē║VTHęį╔ŽĄ─(š²)ļŖē║Ż¼į┌¢┼śOļŖśOš²Ž┬ĘĮĄ─pīė╔Žą╬│╔Ę┤ą═īė(£ŽĄ└)Ż¼ķ_╩╝Å─░l╔õśOļŖśOŽ┬Ą─n-īėūó╚ļļŖūėĪŻįōļŖūė×ķp+n-pŠ¦¾w╣▄Ą─╔┘öĄ▌d┴„ūėŻ¼Å─╝»ļŖśOęrĄūp+īėķ_╩╝┴„╚ļ┐šč©Ż¼▀MąąļŖī¦┬╩š{ųŲ(ļpśO╣żū„)Ż¼╦∙ęį┐╔ęįĮĄĄ═╝»ļŖśO-░l╔õśOķg’¢║═ļŖē║ĪŻ╣żū„ĢrĄ─Ą╚ą¦ļŖ┬Ę╚ńłD1(b)╦∙╩ŠŻ¼IGBTĄ─Ę¹╠¢╚ńłD1(c)╦∙╩ŠĪŻį┌░l╔õśOļŖśOé╚ą╬│╔n+pn-╝─╔·Š¦¾w╣▄ĪŻ╚¶n+pn-╝─╔·Š¦¾w╣▄╣żū„Ż¼ėųūā│╔p+n- pn+Š¦ķl╣▄ĪŻļŖ┴„└^└m┴„äėŻ¼ų▒ĄĮ▌ö│÷é╚═Żų╣╣®ĮoļŖ┴„ĪŻ═©▀^▌ö│÷ą┼╠¢ęč▓╗─▄▀Mąą┐žųŲĪŻę╗░Ńīó▀@ĘNĀŅæBĘQ×ķķ]µiĀŅæBĪŻ
ĪĪĪĪ×ķ┴╦ęųųŲn+pn-╝─╔·Š¦¾w╣▄Ą─╣żū„IGBT▓╔ė├▒M┴┐┐sąĪp+n-pŠ¦¾w╣▄Ą─ļŖ┴„Ę┼┤¾ŽĄöĄ”┴ū„×ķĮŌøQķ]µiĄ─┤ļ╩®ĪŻŠ▀¾wĄžüĒšfŻ¼p+n-pĄ─ļŖ┴„Ę┼┤¾ŽĄöĄ”┴įOėŗ×ķ0.5ęįŽ┬ĪŻ IGBTĄ─ķ]µiļŖ┴„IL×ķŅ~Č©ļŖ┴„(ų▒┴„)Ą─3▒Čęį╔ŽĪŻIGBTĄ─“īäėįŁ└Ē┼cļŖ┴”MOSFET╗∙▒ŠŽÓ═¼Ż¼═©öÓė╔¢┼╔õśOļŖē║uGEøQČ©ĪŻ
ĪĪĪĪī¦═©
ĪĪĪĪIGBT╣ĶŲ¼Ą─ĮYśŗ┼c╣”┬╩MOSFET Ą─ĮYśŗ╩«ĘųŽÓ╦ŲŻ¼ų„ę¬▓Ņ«É╩ŪIGBTį÷╝ė┴╦P+ ╗∙Ų¼║═ę╗éĆN+ ŠÅø_īė(NPT-ĘŪ┤®═©-IGBT╝╝ągø]ėąį÷╝ė▀@éĆ▓┐Ęų)Ż¼Ųõųąę╗éĆMOSFET“īäėā╔éĆļpśOŲ„╝■ĪŻ╗∙Ų¼Ą─æ¬ė├į┌╣▄¾wĄ─P+║═N+ ģ^ų«ķgäōĮ©┴╦ę╗éĆJ1ĮYĪŻ«öš²¢┼Ų½ē║╩╣¢┼śOŽ┬├µĘ┤č▌P╗∙ģ^ĢrŻ¼ę╗éĆN£ŽĄ└ą╬│╔Ż¼═¼Ģr│÷¼Fę╗éĆļŖūė┴„Ż¼▓ó═Ļ╚½░┤šš╣”┬╩MOSFETĄ─ĘĮ╩Į«a╔·ę╗╣╔ļŖ┴„ĪŻ╚ń╣¹▀@éĆļŖūė┴„«a╔·Ą─ļŖē║į┌0.7VĘČć·ā╚Ż¼─Ū├┤Ż¼J1īó╠Äė┌š²Ž“Ų½ē║Ż¼ę╗ą®┐šč©ūó╚ļN-ģ^ā╚Ż¼▓óš{š¹ĻÄĻ¢śOų«ķgĄ─ļŖūĶ┬╩Ż¼▀@ĘNĘĮ╩ĮĮĄĄ═┴╦╣”┬╩ī¦═©Ą─┐éōp║─Ż¼▓óåóäė┴╦Ą┌Č■éĆļŖ║╔┴„ĪŻūŅ║¾Ą─ĮY╣¹╩ŪŻ¼į┌░ļī¦¾wīė┤╬ā╚┼RĢr│÷¼Fā╔ĘN▓╗═¼Ą─ļŖ┴„═žōõŻ║ę╗éĆļŖūė┴„(MOSFET ļŖ┴„);┐šč©ļŖ┴„(ļpśO)ĪŻuGE┤¾ė┌ķ_åóļŖē║UGE(th)ĢrŻ¼MOSFETā╚ą╬│╔£ŽĄ└Ż¼×ķŠ¦¾w╣▄╠ß╣®╗∙śOļŖ┴„Ż¼IGBTī¦═©ĪŻ
ĪĪĪĪī¦═©ē║ĮĄ
ĪĪĪĪļŖī¦š{ųŲą¦æ¬╩╣ļŖūĶRN£pąĪŻ¼╩╣═©æBē║ĮĄąĪĪŻ
ĪĪĪĪĻPöÓ
ĪĪĪĪ«öį┌¢┼śO╩®╝ėę╗éĆžōŲ½ē║╗“¢┼ē║Ą═ė┌ķTŽ▐ųĄĢrŻ¼£ŽĄ└▒╗Į¹ų╣Ż¼ø]ėą┐šč©ūó╚ļN-ģ^ā╚ĪŻį┌╚╬║╬ŪķørŽ┬Ż¼╚ń╣¹MOSFETļŖ┴„į┌ķ_ĻPļAČ╬čĖ╦┘Ž┬ĮĄŻ¼╝»ļŖśOļŖ┴„ätųØuĮĄĄ═Ż¼▀@╩Ūę“×ķōQŽ“ķ_╩╝║¾Ż¼į┌Nīėā╚▀Ć┤µį┌╔┘öĄĄ─▌d┴„ūė(╔┘ūė)ĪŻ▀@ĘNÜłėÓļŖ┴„ųĄ(╬▓┴„)Ą─ĮĄĄ═Ż¼═Ļ╚½╚ĪøQė┌ĻPöÓĢrļŖ║╔Ą─├▄Č╚Ż¼Č°├▄Č╚ėų┼cÄūĘNę“╦žėąĻPŻ¼╚ńōĮļs┘|Ą─öĄ┴┐║══žōõŻ¼īė┤╬║±Č╚║═£žČ╚ĪŻ╔┘ūėĄ─╦ź£p╩╣╝»ļŖśOļŖ┴„Š▀ėą╠žš„╬▓┴„▓©ą╬Ż¼╝»ļŖśOļŖ┴„ę²ŲęįŽ┬å¢Ņ}Ż║╣”║─╔²Ė▀;Į╗▓µī¦═©å¢Ņ}Ż¼╠žäe╩Ūį┌╩╣ė├└m┴„Č■śO╣▄Ą─įOéõ╔ŽŻ¼å¢Ņ}Ė³╝ė├„’@ĪŻ
ĪĪĪĪĶbė┌╬▓┴„┼c╔┘ūėĄ─ųžĮMėąĻPŻ¼╬▓┴„Ą─ļŖ┴„ųĄæ¬┼cąŠŲ¼Ą─£žČ╚ĪóIC ║═VCE├▄ŪąŽÓĻPĄ─┐šč©ęŲäėąįėą├▄ŪąĄ─ĻPŽĄĪŻę“┤╦Ż¼Ė∙ō■╦∙▀_ĄĮĄ─£žČ╚Ż¼ĮĄĄ═▀@ĘNū„ė├į┌ĮKČ╦įOéõįOėŗ╔ŽĄ─ļŖ┴„Ą─▓╗└ĒŽļą¦æ¬╩Ū┐╔ąąĄ─Ż¼╬▓┴„╠žąį┼cVCEĪóIC║═ TCėąĻPĪŻ
ĪĪĪĪ¢┼╔õśOķg╩®╝ėĘ┤ē║╗“▓╗╝ėą┼╠¢ĢrŻ¼MOSFETā╚Ą─£ŽĄ└Ž¹╩¦Ż¼Š¦¾w╣▄Ą─╗∙śOļŖ┴„▒╗ŪąöÓŻ¼IGBTĻPöÓĪŻ
ĪĪĪĪĘ┤Ž“ūĶöÓ
ĪĪĪĪ«ö╝»ļŖśO▒╗╩®╝ėę╗éĆĘ┤Ž“ļŖē║ĢrŻ¼J1 Š═Ģ■╩▄ĄĮĘ┤Ž“Ų½ē║┐žųŲŻ¼║─▒MīėätĢ■Ž“N-ģ^öUš╣ĪŻę“▀^ČÓĄžĮĄĄ═▀@éĆīė├µĄ─║±Č╚Ż¼īó¤oĘ©╚ĪĄ├ę╗éĆėąą¦Ą─ūĶöÓ─▄┴”Ż¼╦∙ęįŻ¼▀@éĆÖCųŲ╩«Ęųųžę¬ĪŻ┴Ēę╗ĘĮ├µŻ¼╚ń╣¹▀^┤¾Ąžį÷╝ė▀@éĆģ^ė“│▀┤ńŻ¼Š═Ģ■▀B└mĄž╠ßĖ▀ē║ĮĄĪŻ
ĪĪĪĪš²Ž“ūĶöÓ
ĪĪĪĪ«ö¢┼śO║═░l╔õśOČ╠Įė▓óį┌╝»ļŖśOČ╦ūė╩®╝ėę╗éĆš²ļŖē║ĢrŻ¼P/NJ3ĮY╩▄Ę┤Ž“ļŖē║┐žųŲĪŻ┤╦ĢrŻ¼╚į╚╗╩Ūė╔NŲ»ęŲģ^ųąĄ─║─▒Mīė│ą╩▄═Ō▓┐╩®╝ėĄ─ļŖē║ĪŻ
ĪĪĪĪķVµi
ĪĪĪĪIGBTį┌╝»ļŖśO┼c░l╔õśOų«ķgėąę╗éĆ╝─╔·PNPNŠ¦ķl╣▄ĪŻį┌╠ž╩ŌŚl╝■Ž┬Ż¼▀@ĘN╝─╔·Ų„╝■Ģ■ī¦═©ĪŻ▀@ĘN¼FŽ¾Ģ■╩╣╝»ļŖśO┼c░l╔õśOų«ķgĄ─ļŖ┴„┴┐į÷╝ėŻ¼ī”Ą╚ą¦MOSFETĄ─┐žųŲ─▄┴”ĮĄĄ═Ż¼═©│Ż▀ĆĢ■ę²ŲŲ„╝■ō¶┤®å¢Ņ}ĪŻŠ¦ķl╣▄ī¦═©¼FŽ¾▒╗ĘQ×ķIGBTķVµiŻ¼Š▀¾wĄžšfŻ¼▀@ĘN╚▒Ž▌Ą─įŁę“╗ź▓╗ŽÓ═¼Ż¼┼cŲ„╝■Ą─ĀŅæBėą├▄ŪąĻPŽĄĪŻ═©│ŻŪķørŽ┬Ż¼ņoæB║═äėæBķVµiėą╚ńŽ┬ų„ę¬ģ^äeŻ║
ĪĪĪĪ╩ĮųąImos Ī¬Ī¬┴„▀^MOSFET Ą─ļŖ┴„ĪŻ
ĪĪĪĪų╗į┌ĻPöÓĢr▓┼Ģ■│÷¼FäėæBķVµiĪŻ▀@ę╗╠ž╩Ō¼FŽ¾ć└ųžĄžŽ▐ųŲ┴╦░▓╚½▓┘ū„ģ^ĪŻ
ĪĪĪĪ×ķĘ└ų╣╝─╔·NPN║═PNPŠ¦¾w╣▄Ą─ėą║”¼FŽ¾Ż¼ėą▒žę¬▓╔╚ĪęįŽ┬┤ļ╩®Ż║ę╗╩ŪĘ└ų╣NPN▓┐ĘųĮė═©Ż¼ĘųäeĖ─ūā▓╝Šų║═ōĮļs╝ēäeŻ╗Č■╩ŪĮĄĄ═NPN║═PNPŠ¦¾w╣▄Ą─┐éļŖ┴„į÷ęµĪŻ
ĪĪĪĪ┤╦═ŌŻ¼ķVµiļŖ┴„ī”PNP║═NPNŲ„╝■Ą─ļŖ┴„į÷ęµėąę╗Č©Ą─ė░ĒæŻ¼ę“┤╦Ż¼╦³┼cĮY£žĄ─ĻPŽĄę▓ĘŪ│Ż├▄Ūą;į┌ĮY£ž║═į÷ęµ╠ßĖ▀Ą─ŪķørŽ┬Ż¼P╗∙ģ^Ą─ļŖūĶ┬╩Ģ■╔²Ė▀Ż¼ŲŲē─┴╦š¹¾w╠žąįĪŻę“┤╦Ż¼Ų„╝■ųŲįņ╔╠▒žĒÜūóęŌīó╝»ļŖśOūŅ┤¾ļŖ┴„ųĄ┼cķVµiļŖ┴„ų«ķg▒Ż│ųę╗Č©Ą─▒╚└²Ż¼═©│Ż▒╚└²×ķ1Ż║5ĪŻ


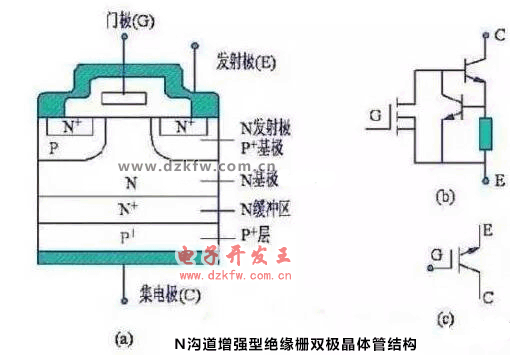

 ĘĄ╗žĒö▓┐
ĘĄ╗žĒö▓┐ ╦óą┬Ēō├µ
╦óą┬Ēō├µ Ž┬ĄĮĒōĄū
Ž┬ĄĮĒōĄū